Ball-Grid-Array (BGA) Solder Joints 是高科技、交通运输和航空等领域芯片制作工艺中,重要的一环。
振兴中华,自助开发芯片势在必行。

BGA焊点的设计挑战,
主要为疲劳失效Fatigue and Failure


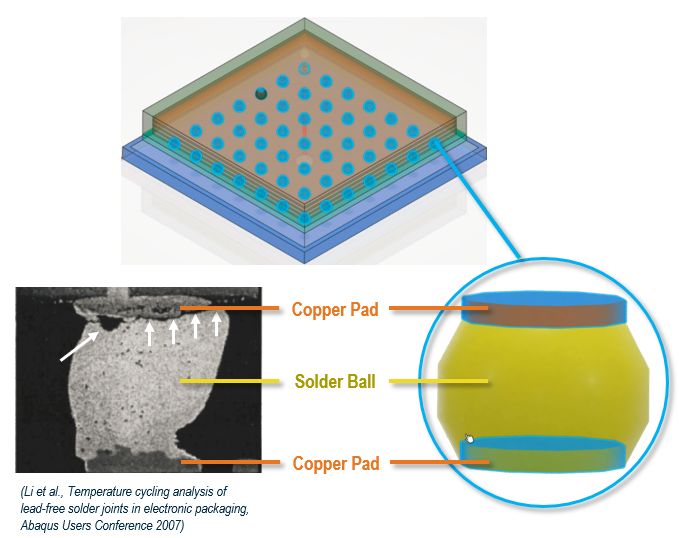
焊球参数化建模。采用BGA Plugin for Abaqus/CAE插件,对焊球进行参数化建模。
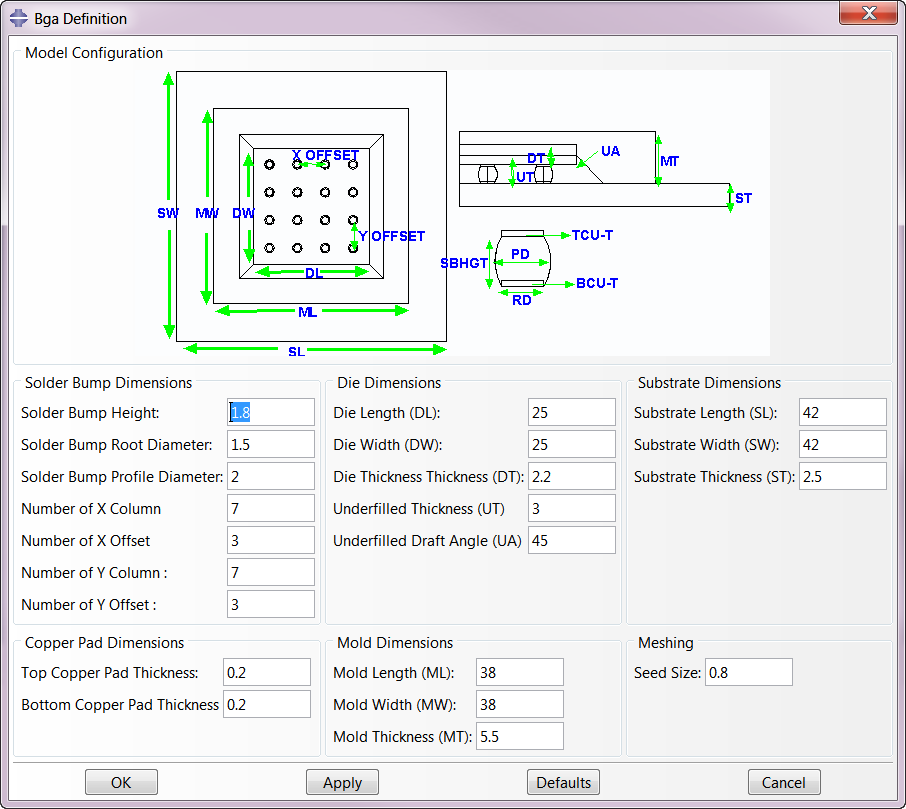
网格划分
先划分局部、再阵列、最后布尔合并网格。


材料参数
采用与温度相关的动态硬化弹塑性模型,同时考虑材料的各向异性。

当然,也可采用Abaqus内嵌的Anand creep model进行蠕变分析。
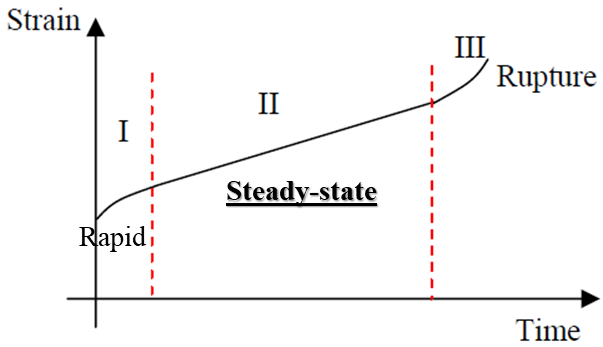
分析结果

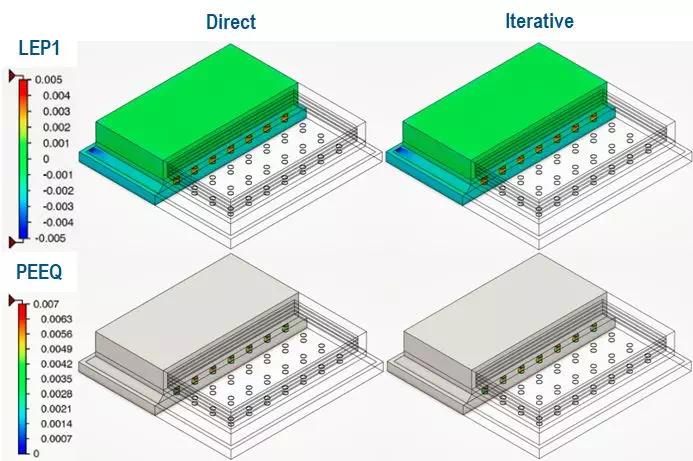
总结

免责声明:本文系网络转载或改编,未找到原创作者,版权归原作者所有。如涉及版权,请联系删
武汉格发信息技术有限公司,格发许可优化管理系统可以帮你评估贵公司软件许可的真实需求,再低成本合规性管理软件许可,帮助贵司提高软件投资回报率,为软件采购、使用提供科学决策依据。支持的软件有: CAD,CAE,PDM,PLM,Catia,Ugnx, AutoCAD, Pro/E, Solidworks ,Hyperworks, Protel,CAXA,OpenWorks LandMark,MATLAB,Enovia,Winchill,TeamCenter,MathCAD,Ansys, Abaqus,ls-dyna, Fluent, MSC,Bentley,License,UG,ug,catia,Dassault Systèmes,AutoDesk,Altair,autocad,PTC,SolidWorks,Ansys,Siemens PLM Software,Paradigm,Mathworks,Borland,AVEVA,ESRI,hP,Solibri,Progman,Leica,Cadence,IBM,SIMULIA,Citrix,Sybase,Schlumberger,MSC Products...